【柔性電路板技術前沿】三星電子用新技術替代SAP工藝,用于Fan-Out封裝
三星電子為了加強下一代“Fan-Out(FO)”封裝技術,引入了一種新工藝替代SAP工藝。為了應對HBM(High Bandwidth Memory)等先進半導體的日益普及,計劃采用新的封裝工藝來提高基板的集成度。
4月12日,三星電子團隊負責人Lee Chung-seon在“2023年先進半導體封裝創新工藝大會”上,公布了下一代封裝技術路線圖,該會議在韓國首爾舉行。

三星電子團隊負責人Lee Chung-seon在“2023年先進半導體封裝創新工藝大會”上發表主題演講▲
據柔性電路板廠了解:三星電子去年底新設了專門負責先進封裝的AVP業務團隊,一直專注于開發相關技術。目前,三星電子重點布局的先進封裝有兩個領域:扇出型(FO)、3D等小芯片封裝和2.5D、3.5D等大芯片封裝。
其中,扇出型(FO)封裝是一種將輸入/輸出(I/O)端子線路引出芯片外部的技術。可以在外部放置更多的I/O端子,并縮短半導體和主板之間的布線長度,從而提高電氣性能和熱效率。三星電子已經開發并量產了FO-WLP、FO-PLP等技術,分別應用于晶圓級封裝和矩形面板封裝。
然而,它面臨的挑戰是巨大的。扇出型(FO)封裝為了應對HBM等下一代存儲器,必須進一步縮小電路板(PCB)的電路間隔。HBM是將多個DRAM垂直連接在一起的半導體,具有更高的帶寬,可以更快地傳輸數據。
團隊負責人Lee Choong-seon表示:“目前,通過SAP工藝,可以在電路板上實現2/2微米的線路間距。如果HBM技術變得更先進,則需要將間距減少到1/1微米或更小,但通過SAP工藝存在限制。”
因此,三星電子正在考慮將Damascene工藝作為SAP工藝的替代方案引入。Damascene是一種在電路部分形成凹槽,并通過電解沉積形成電路的工藝。
Lee補充說:“Damascene工藝是實現下一代扇出型(FO)封裝微細電路的重要方向。”
“2023年先進半導體封裝創新工藝大會”是由電子行業媒體THE ELEC和電子知識頻道YiLec共同舉辦的活動,旨在探討在半導體行業中越來越重要的先進封裝材料和工藝技術。韓國封裝領域的主要公司參加了本次會議,包括三星電子、SK海力士、Stats Chippack Korea、LG化學、Henkel、MK Electronics和Cadence Korea等。
封裝是一種將加工完成的晶圓切割成芯片并進行包裝的后工藝技術。由于微型化電路的前工藝技術逐漸達到瓶頸,業界一直在開發能提高半導體性能和效率的先進封裝技術來代替前工藝。特別是,有效去除芯片產生的熱量的散熱技術和耐高溫保持芯片性能的耐熱技術正在成為主要課題。
ps:部分圖片來源于網絡,如有侵權,請聯系我們刪除
最新產品
醫療設備控制器軟板
-

-
型 號:RS04C00269A
層 數:4
板 厚:0.3mm
材 料:雙面無膠電解材料
銅 厚:1/2 OZ
特 點:產品都經過100%燒錄測試
表面處理:沉金2微英寸
最小線寬/線距:0.07mm/0.06mm
數碼相機軟板
數碼相機軟板
手機電容屏軟板
-

-
型 號:RM02C00712A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3OZ表面處理:沉金1微英寸最小線寬/線距:0.05mm/0.05mm電磁膜:2面特 點:產品都經過100%燒錄測試
手機電容屏軟板
-
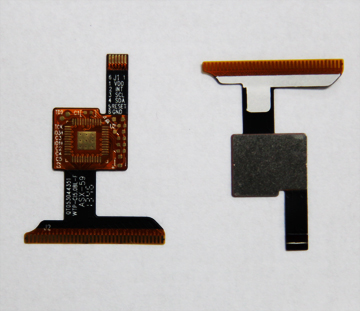
-
型 號:RS02C00244A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ特 點:產品都經過100%燒錄測試表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.06mm電磁膜:2面
手機電容屏軟板
-
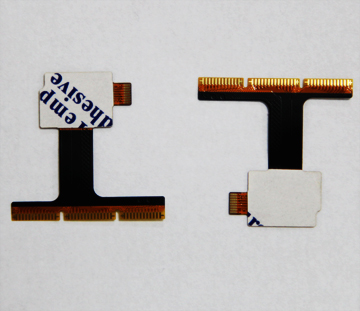
-
型 號:RM02C00247A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ表面處理:沉金1微英寸最小線寬/線距:0.07mm/0.07mm電磁膜:2面特 點:產品都經過100%燒錄測試
手機電容屏軟板
-
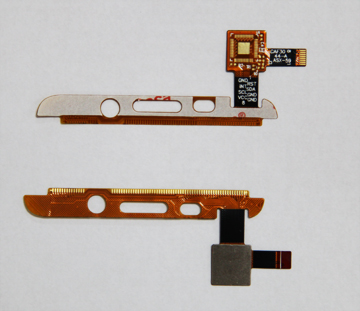
-
型 號:RM02C00892A層 數:2板 厚:0.12mm材 料:雙面無膠電解銅 厚:1/3 OZ表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.05mm電磁膜:2面其 他:產品都經過100%燒錄測試
醫療按鍵軟板
同類文章排行
- 2014年中國柔性線路板廠綜合排名——有幾家是你熟識的呢?
- 柔性電路板|| 2017年度中國電子電路PCB百強企業排行榜
- 指紋模塊FPC小編帶您一文了解指紋識別,看完全懂了!
- 手機FPC廠之2017年度全球PCB百強企業排行榜
- FPC廠從八個角度讓你讀懂指紋識別
- 2015年NTI-100全球電路板百強企業排行榜,其中中國大陸上榜企業有34家!
- pcb廠家盤點俄軍經典AK系列步槍
- 指紋識別軟板之各類FPC在指紋模組中的應用
- fpc軟板廠家為你解析黑孔工藝
- 柔性線路板給你推送的最新資訊‖2016中國印制電路板行業50強
最新資訊文章
- 新能源汽車動力之電池FPC補強整體解決方案
- FPC廠家帶您了解指紋識別軟板的POS機
- 你了解線路板軟板品質意識有哪些方面的內容嗎?
- 探索柔性線路板的奧秘并揭秘廠家常用PCB板材
- 電子產業中不可缺的一環——軟板廠
- 如何選擇高品質柔性電路板?
- 介紹FPC廠FPC與PCB廠PCB
- 2024年深聯親子活動報名已開啟,快來報名吧!
- 指紋識別軟板的技術成果有哪些?
- 【熱點 】電動汽車軟板用量大 臺廠卡位布局









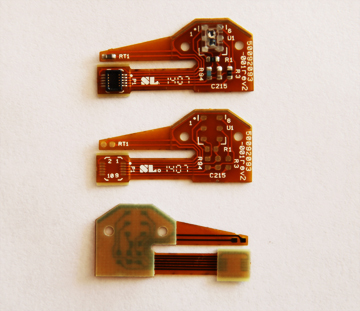





共-條評論【我要評論】