柔性電路板上倒裝芯片組裝技術(shù)解析
柔性電路板上倒裝芯片組裝技術(shù)解析
由思想來控制機(jī)器的能力是人們長久以來的夢想;尤其是為了癱瘓的那些人。近年來,工藝的進(jìn)步加速了人腦機(jī)器界面(BMI)的進(jìn)展。針對生物醫(yī)學(xué)的應(yīng)用,杜克大學(xué)的研究者已經(jīng)成功地利用神經(jīng)探針開發(fā)出訊號處理的ASIC,以及無線傳輸動力與信息的電子電路系統(tǒng)。再下一步,就是開發(fā)組件的封裝技術(shù)。然而,這些組件將如何相互聯(lián)接呢?
尺寸和可靠性對生物醫(yī)學(xué)用的植入物而言,是最重要的兩個要素。微電子業(yè)的兩個封裝技術(shù)(倒裝芯片接合和柔性載板)正好適用于這個應(yīng)用。倒裝芯片接合技術(shù)已經(jīng)發(fā)展30多年了。此一技術(shù)的優(yōu)點是體積小、接線密度高,而且因為引腳短而電性得以改善4。倒裝芯片接合技術(shù)的另一個優(yōu)勢,是能夠?qū)⒍鄠€不同尺寸的芯片封裝在同一片載板上,構(gòu)成多芯片模塊。這種封裝方式能免除又大又不可靠的連接器。

此外,由聚亞酰胺(polyimide)做成的柔性載板能夠彎曲和折迭,可以充分利用空間做成體積小的組件。但因為聚亞酰胺材料僅適用于低溫接合技術(shù)(制程溫度低于攝氏200度),所以必須使用熱硬化黏膠,而非焊錫來提供機(jī)械性和電性的聯(lián)結(jié)。在這個研究中,我們使用低成本的柱形金凸塊技術(shù),而非其它類似應(yīng)用中所采用的錫鉛凸塊技術(shù)。
為了發(fā)展適用于生物醫(yī)學(xué)應(yīng)用的制程,我們設(shè)計并以聚亞酰胺為基材制造測試芯片。這些測試芯片在打上柱形金凸塊后,被用來驗證制程。我們分別測試了導(dǎo)電和絕緣的熱硬化黏膠,并在做過溫度循環(huán)測試后,測量接觸電阻以評量產(chǎn)品的可靠性。
接合技術(shù)
我們希望能夠使用柱形金凸塊技術(shù)和熱硬化黏膠,發(fā)展一個可靠的制程,將切割后的芯片接合在柔性載板上。在這個研究中,我們測試了兩個接合的方法;第一個方法使用絕緣的熱硬化黏膠、第二個方法使用導(dǎo)電黏膠和絕緣的底部填充膠。每一個測試組件都由測試電路載板和仿真芯片(dummychip)所組成。管腳陣列封裝的載板也被設(shè)計在同一片聚亞酰胺載板上,以便于未來用于測試神經(jīng)訊號放大器芯片。

仿真芯片的制備:為了使軟性的仿真芯片能像硅芯片一樣硬,我們得在這個軟性的仿真芯片背部加上一個加強(qiáng)性構(gòu)件。可是由載板制造商提供的加強(qiáng)性構(gòu)件太軟了,所以我們用一小塊1毫米厚的顯微鏡用的載玻片取代制造商所提供的加強(qiáng)性構(gòu)件。柱形金凸塊:測試中所使用的仿真芯片和芯片的柱形金凸塊都是用手動金球焊線機(jī)(Kulicke&Soffa抯4524AD)做出來的。
絕緣的熱硬化黏膠接合:在絕緣的熱硬化黏膠接合方法中,長了柱形金凸塊的芯片和載板用絕緣的熱硬化黏膠接合。芯片和載板的對準(zhǔn)和接合是用倒裝芯片接合機(jī)(SUSSMicrotec抯FC150)。接合的步驟如下:
1.將長了柱形金凸塊的芯片和載板裝載到倒裝芯片接合機(jī)。
2.芯片和載板由倒裝芯片接合機(jī)對準(zhǔn)。
3.將絕緣的熱硬化黏膠涂布在載板上。
4.依表2與圖3的條件將芯片與載板接合。
5.黏膠在接合的壓力下被熱硬化,然后在釋壓前冷卻下來。
導(dǎo)電黏膠的接合技術(shù)
在導(dǎo)電黏膠的接合方法中,先將長好柱形金凸塊的芯片放入銀膠的薄層。再把這個沾了銀膠的芯片用絕緣的熱硬化黏膠與載板接合。芯片和載板的對準(zhǔn)和接合也是使用倒裝芯片接合機(jī)。接合的步驟如下:
1.將長了柱形金凸塊的芯片裝載到倒裝芯片接合機(jī)。
2.將載玻片放在放載板的吸盤上。
3.將薄薄的一層導(dǎo)電銀膠在涂布在載玻片上。注意:將導(dǎo)電銀膠稀釋10%以達(dá)成較好的沾膠效果。
4.用倒裝芯片接合機(jī)將導(dǎo)電銀膠延展成30微米厚。
5.將長了柱形金凸塊的芯片壓入30微米厚的導(dǎo)電銀膠層。
6.取走載玻片,然后放入載板。
7.在載板上涂布絕緣的熱硬化黏膠。
8.將芯片與載板對準(zhǔn),然后透過黏膠與載板接合。
9.黏膠在接合的壓力被熱硬化,然后在釋壓前冷卻下來。
溫度循環(huán)測試:溫度循環(huán)測試經(jīng)常被用來驗證接合點的可靠度。在溫度循環(huán)測試期間,每30秒就記錄一次溫度和仿真芯片上一對凸塊間的電阻。
溫度循環(huán)測試的溫度變化條件設(shè)定如下:
1.保持在攝氏85度,10分鐘。
2.以最快的速度降溫到攝氏零下10度。
3.保持在攝氏零下10度,10分鐘。
4.以最快的速度升溫到攝氏85度。
5.重復(fù)這個溫度變化周期。
將仿真芯片從聚亞酰胺基材上切割下來,黏合載玻片以加強(qiáng)軟性仿真芯片的結(jié)構(gòu)強(qiáng)度,打上柱形金凸塊,然后以前述的兩種方法(絕緣的熱硬化黏膠接合技術(shù)、導(dǎo)電的熱硬化黏膠接合技術(shù))將仿真芯片與柔性載板接合起來。由于這個做在聚亞酰胺基材上的仿真芯片是半透明的,我們能夠以目檢檢視接合的界面。柱形金凸塊看起來是很平均的被壓縮,這表示平面度控制得很好。對準(zhǔn)的精確度控制在3微米之內(nèi)。可以看到在黏膠層之內(nèi)有一些空氣氣泡,但是,這些空氣氣泡看來并不會影響效能。
使用柱形金凸塊和黏膠的接合技術(shù)有幾個優(yōu)點。首先,這個方法適用于已切割的芯片。實際上,使用軟性的仿真芯片作為測試組件,是一個發(fā)展接合技術(shù)的較廉價且實際的方法。而半透明的測試組件更是使用聚亞酰胺做為基材時所未預(yù)料到好處。由于測試組件是半透明的,我們可以輕易的使用光學(xué)微鏡來檢查接合的質(zhì)量。使用絕緣的熱硬化黏膠接合技術(shù),制程步驟較為簡單,并且不需要清洗步驟與額外的底部填充膠。在導(dǎo)電黏膠的接合方法中有幾個步驟需要非常小心的控制,尤其是涂布銀膠與沾膠。此外,為了機(jī)械強(qiáng)度的考慮,需要增加涂底部填充膠的步驟。這兩個方法的共通缺點就是黏膠固化時間(10分鐘)太長;就研究而言,這是可接受的。然而,就量產(chǎn)而言,一種固化時間更短的黏膠是有必要的。我們相信黏膠和底部填充膠被固化時,能將芯片和載板拉緊,因而強(qiáng)化了接合的質(zhì)量。在溫度循環(huán)測試中,絕緣的熱硬化黏膠接合技術(shù)的平均電阻,符合我們的預(yù)期;這個結(jié)果也和其它單位的結(jié)果相當(dāng)。使用絕緣的熱硬化黏膠接合技術(shù),在柔性載板做倒裝芯片接合所制備的組件與商業(yè)化生產(chǎn)的陶瓷管腳陣列封裝組件,在電性上的表現(xiàn)是一致的。此外,此一技術(shù)還有體積小與能適用于不同形狀的優(yōu)勢。
為了以倒裝芯片封裝將神經(jīng)訊號放大器的ASICS芯片接合上柔性載板,我們開發(fā)并評估了兩種接合方法,并用制造于聚亞酰胺基材上的仿真芯片做制程的開發(fā)與測試。基于制程簡單與可靠性佳的考慮,我們選用絕緣的熱硬化黏膠接合技術(shù)與柱形金凸塊技術(shù)。我們也用這個方法將神經(jīng)訊號放大器的ASICS芯片接合上管腳陣列封裝載板。第一個試做就產(chǎn)出了一個100%功能良好的產(chǎn)品。
ps:部分圖片來源于網(wǎng)絡(luò),如有侵權(quán),請聯(lián)系我們刪除
最新產(chǎn)品
醫(yī)療設(shè)備控制器軟板
-

-
型 號:RS04C00269A
層 數(shù):4
板 厚:0.3mm
材 料:雙面無膠電解材料
銅 厚:1/2 OZ
特 點:產(chǎn)品都經(jīng)過100%燒錄測試
表面處理:沉金2微英寸
最小線寬/線距:0.07mm/0.06mm
數(shù)碼相機(jī)軟板
數(shù)碼相機(jī)軟板
-

-
型 號:RM01C00187A層 數(shù):1板 厚:0.12mm材 料:單面有膠電解銅 厚:1/2 OZ表面處理:沉金2微英寸最小線寬/線距:0.1mm/0.08mm特 點:外形復(fù)雜
手機(jī)電容屏軟板
-

-
型 號:RM02C00712A層 數(shù):2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3OZ表面處理:沉金1微英寸最小線寬/線距:0.05mm/0.05mm電磁膜:2面特 點:產(chǎn)品都經(jīng)過100%燒錄測試
手機(jī)電容屏軟板
-
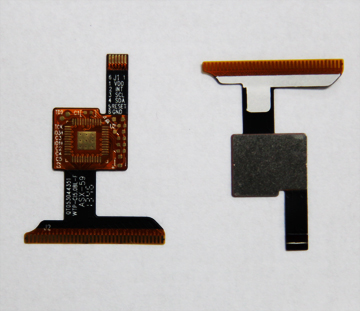
-
型 號:RS02C00244A層 數(shù):2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ特 點:產(chǎn)品都經(jīng)過100%燒錄測試表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.06mm電磁膜:2面
手機(jī)電容屏軟板
-
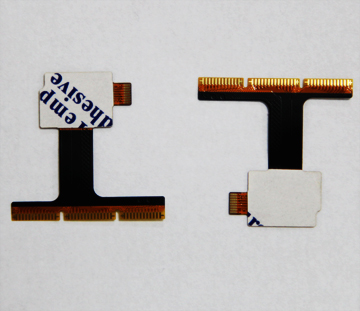
-
型 號:RM02C00247A層 數(shù):2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ表面處理:沉金1微英寸最小線寬/線距:0.07mm/0.07mm電磁膜:2面特 點:產(chǎn)品都經(jīng)過100%燒錄測試
手機(jī)電容屏軟板
-
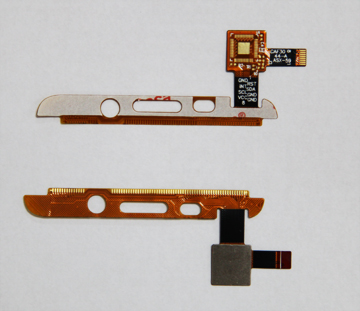
-
型 號:RM02C00892A層 數(shù):2板 厚:0.12mm材 料:雙面無膠電解銅 厚:1/3 OZ表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.05mm電磁膜:2面其 他:產(chǎn)品都經(jīng)過100%燒錄測試
醫(yī)療按鍵軟板
同類文章排行
- 2014年中國柔性線路板廠綜合排名——有幾家是你熟識的呢?
- 柔性電路板|| 2017年度中國電子電路PCB百強(qiáng)企業(yè)排行榜
- 指紋模塊FPC小編帶您一文了解指紋識別,看完全懂了!
- 手機(jī)FPC廠之2017年度全球PCB百強(qiáng)企業(yè)排行榜
- FPC廠從八個角度讓你讀懂指紋識別
- 2015年NTI-100全球電路板百強(qiáng)企業(yè)排行榜,其中中國大陸上榜企業(yè)有34家!
- pcb廠家盤點俄軍經(jīng)典AK系列步槍
- 指紋識別軟板之各類FPC在指紋模組中的應(yīng)用
- fpc軟板廠家為你解析黑孔工藝
- 柔性線路板給你推送的最新資訊‖2016中國印制電路板行業(yè)50強(qiáng)
最新資訊文章
- 汽車FPC在汽車電子領(lǐng)域的應(yīng)用
- 新能源汽車動力之電池FPC補(bǔ)強(qiáng)整體解決方案
- FPC廠家?guī)私庵讣y識別軟板的POS機(jī)
- 你了解線路板軟板品質(zhì)意識有哪些方面的內(nèi)容嗎?
- 探索柔性線路板的奧秘并揭秘廠家常用PCB板材
- 電子產(chǎn)業(yè)中不可缺的一環(huán)——軟板廠
- 如何選擇高品質(zhì)柔性電路板?
- 介紹FPC廠FPC與PCB廠PCB
- 2024年深聯(lián)親子活動報名已開啟,快來報名吧!
- 指紋識別軟板的技術(shù)成果有哪些?




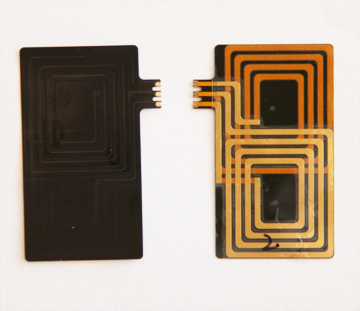
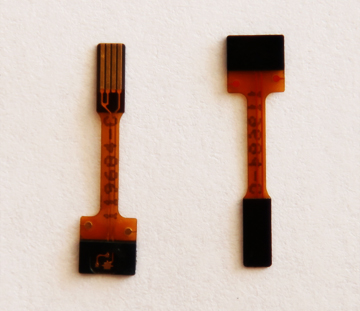
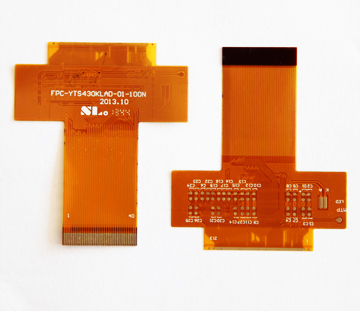








共-條評論【我要評論】