一文讀懂高密度FPC軟板
一、高密度PCB軟板定義:
一般是從細線與微孔的制程能力來定義高密度PCB軟板,線間距(Pitch)小于150μm,微孔孔徑小于150μm(IPC之定義)都可說是高密度PCB軟板,而超高密度PCB軟板,則是進一步縮小。應用高密度PCB軟板可區分幾個領域:
A.IC載板:如CSP、BGA等
B.資訊產品:如硬碟(Hard Disk)、噴墨印表機(Ink Jet Printer)
C.消費性產品:如照相機(Camera)、行動電話(Mobile Phone)
D.辦公室自動化產品:如傳真機(Facsimile Machine)
E.醫療產品:如助聽器(Hearingaid)、電擊器(Defibrillator)
F.LCD模組
從可以知道近兩年高密度PCB軟板需求成長較傳統FPC要高很多,本文針對幾種需求量較大的高密度PCB軟板做一整理介紹。

二、應用
1.TBGA(Tape Ball Grid Array)
IC構裝一直朝輕量化發展,許多公司設計使用軟板當做IC載板,除了高密度外,優異的熱傳及電性也是考慮使用的主因。
TBGA是使用軟板當做IC的載體,具有細線及薄型效果,目前應用以一層金屬銅較多,二層金屬的使用也逐漸增加。TBGA量產的尺寸由11mm×11mm至42.5mm×42.5mm,腳數由100到768,圖6是SONY公司以軟板為構裝載板的TBGA。最大量的TBGA構裝應是256及352腳數,35mm×35mm的構裝。應用TBGA構裝的產品主要是微處理器、晶片組、記憶體、DSP、ASIC及PC網路系統等。
2.Chip Scale Package
CSP晶片級尺寸構裝CSP的構裝強調晶片尺寸的構裝體積,目前有四種主要的型式,分別為硬質基板(Rigid Substrate)、導線架(Lead Frame)、軟質基板(Flex Interposer)及晶圓型(Wafer Level),其中軟質基板即是采用高密度PCB軟板當做IC承載基板,它跟TBGA最大的不同是在構裝完成后的尺寸,因TBGA是采Fan-out方式構裝,構裝實體較IC大很多,而CSP采用Fan-in方式構裝,實際構裝實體不超過IC的1.2倍,所以有晶片級構裝之稱,使用的構裝IC有Flash記憶體、SILM、ASIC及數位訊號處理器(DSP)等,用途則是在數位相機、攝錄影機、行動電話、記憶卡等產品。一般使用Wire Bonding方式做IC與軟性載板的連接,但近來逐漸使用Flip Chip方式的連接方法。至于與PCB的連接,主要還是以錫球陣列(BGA)方式的為主。CSP整個構裝實體尺寸視IC大小而定,一般尺寸由6m×6mm到17m×17mm,構裝間距則由0.5mm到1.0mm,TI的μStar BGA立體剖面圖,是典型的軟板型CSP構裝代表之一。Tessera的μBGA則是CSP的鼻祖,國內有幾家由其授權生產。
3.LCD驅動IC構裝
過去LCD驅動IC大部分是以高密度PCB軟板的TAB(Tape Automatic Bonding)的方式進行構裝,藉由異方性導電膠(ACF)將TAB外接腳(內接腳與IC Bonding)與LCD面板的ITO電極做導通連接,最小pitch可達50μm。所采用的TAB Tape寬幅為48mm與7mm較多,典型的1/0數目為380,主要的應用產品是行動電話、攝錄影機、筆記型電腦等。不過以TAB方式進行LCD驅動IC的構裝,只單純對驅動IC進行構裝,其它的被動元件還是必須靠另一PCB來承載,如此將造成整個LCD構裝尺寸無法再有效縮小,于是有人開始使用不同于TAB方式但同屬高密度PCB軟板構裝的COF(Chip on Flex)方式來做LCD驅動IC的構裝,COF方式構裝除了可置放驅勸IC外,一些電阻、電容被動元件亦可以表面黏著方式置于其上,解決了再使用比PCB所造成構裝體復雜及過大的問題,這是目前熱門的LCD構裝方式,非常具有潛在的市場,但細線、薄型、及材料附著的議題,將是軟板制造(線寬150μm)、設備研發(50μm以下厚度的傳輸)及材料提供(無膠及銅附著)者的挑戰。
4.噴墨印表機噴墨頭
噴墨印表機的噴墨頭驅動構裝也是采用高密度的軟板,目前采用無接著劑型軟板,解析間距中150μm左右,但有逐漸向下發展的趨勢,使用軟板的寬輻以24mm為最普遍,目前這種高密度PCB軟板幾乎由3M公司所壟斷。
5.硬碟機(HDD)讀取頭
由于資料儲存設備隨資訊、網際網路、數位影像的迅速發展,在儲存容量及存取速度呈現快速成長。不僅僅PC、Notebook的硬碟機的需求而已,汽車用電腦、GPS系統、數位相機與數位攝錄影機的大容量記憶裝置等,都需要用到所謂的R/WFPC—讀寫頭使用的軟板。不僅是高密度結構的設計,對于操作溫度可能高到80℃,以及需要高速動態的震動而不使導線有斷裂的情形,信賴度要求的嚴苛可見一般。
三、發展趨勢與技術要求
1.Fine Lines&Microvia
例如COF的PITCH將減小到25μm~50μm,這將挑戰基材(銅接著力、厚度)、線路制程(感光解析度、蝕刻控制、設備傳動)等。而孔徑小到50μm,甚至更小;也有盲、埋孔的需求,勢必帶動如雷射等非機鉆制程。
2.Microvias
當孔徑小至50μm時,傳統機鉆已無法應付,必須仰賴雷射燒孔,直接蝕刻PI膜,這在IC Substrate如CSP、TAB等最常應用。
3.Flying Leads
有些特殊結構的高密度PCB軟板,可以乾式或濕式方法PI膜蝕除,而留下所謂的飛腳(Flying Leads),可以直接和硬板已熱壓或和焊接連接。
4.Small Coverlay Openings
由于Coverlay Opening解析將達50μm以下,且開口數量大增,傳統沖孔方式已無法做到,因此PIC(Photoimageble Coverlayer)被發展出來,以應付未來需求。
5.Surface Finish
使用于硬板的如化鎳金、電鍍軟硬鎳金、純錫等無鉛制程將是可預期的主流。
6.Microbump Array
CSP、Flip Chip等的信賴度及密集化的要求,MBA勢必是軟板制作的一大挑戰。
7.Dimensional Control
細小化的結果就是精密度亦需大大提高,對于材料選擇、排版設計、設備考量、各制程控制及補嘗值設計等,都是要面臨的極大挑戰。
8.Inspection AOI與非接觸電性測試的搭配檢驗
這是未來解決高密度PCB軟板出貨前檢驗的一參考方向。
結語
軟性基板為了維持高成長率及利潤,勢必朝向高刻度的應用發展,這時必須在材料上同時做改良及突破,其中無接著劑型基材及感光型保護膜二項材料將扮演傳統軟板走入高密度PCB軟板的重要角色。國內在IC及LCD構裝上已有良好基楚,而且在軟板制造能力及規模上也有一定水準,如能搭配國內早已深耕的IC及LCD面板制造能力,在創造新構裝產品及技術上應該有很大的先機及利基。但是別忘了新材料開發是掌握利潤及成本的重要關鍵,如何在上游軟板新材料的研發與制作同步進行,才能確保此一優勢。
根據TechSearch預估傳統板在1999至2004年的年平均成長率為9.8%,HDI軟板的年平均成長率則接近40%,成長幅度為傳統軟板的4倍以上,預估HDI軟板將是未來軟板市場需求的趨勢。而根據Prismark資料顯示,2000年IC Substrate產出為3125000m2,其中軟式PI基材占了約8%,預估2005年,總IC Substrate需求約為9587000m2,成長3倍多,軟式PI基材所占比例提升到11%。所以未來FPC需求的成長是可樂觀期待的。
ps:部分圖片來源于網絡,如有侵權,請聯系我們刪除
最新產品
醫療設備控制器軟板
-

-
型 號:RS04C00269A
層 數:4
板 厚:0.3mm
材 料:雙面無膠電解材料
銅 厚:1/2 OZ
特 點:產品都經過100%燒錄測試
表面處理:沉金2微英寸
最小線寬/線距:0.07mm/0.06mm
數碼相機軟板
數碼相機軟板
手機電容屏軟板
-

-
型 號:RM02C00712A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3OZ表面處理:沉金1微英寸最小線寬/線距:0.05mm/0.05mm電磁膜:2面特 點:產品都經過100%燒錄測試
手機電容屏軟板
-
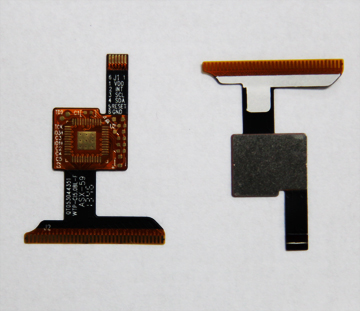
-
型 號:RS02C00244A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ特 點:產品都經過100%燒錄測試表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.06mm電磁膜:2面
手機電容屏軟板
-
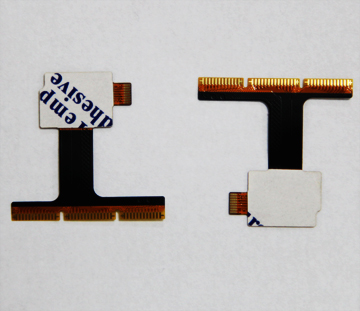
-
型 號:RM02C00247A層 數:2板 厚:0.12mm材 料:雙面無膠電解材料銅 厚:1/3 OZ表面處理:沉金1微英寸最小線寬/線距:0.07mm/0.07mm電磁膜:2面特 點:產品都經過100%燒錄測試
手機電容屏軟板
-
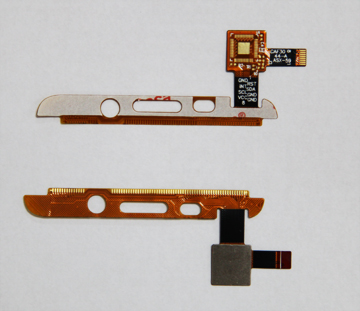
-
型 號:RM02C00892A層 數:2板 厚:0.12mm材 料:雙面無膠電解銅 厚:1/3 OZ表面處理:沉金2微英寸最小線寬/線距:0.07mm/0.05mm電磁膜:2面其 他:產品都經過100%燒錄測試
醫療按鍵軟板
同類文章排行
- 2014年中國柔性線路板廠綜合排名——有幾家是你熟識的呢?
- 柔性電路板|| 2017年度中國電子電路PCB百強企業排行榜
- 指紋模塊FPC小編帶您一文了解指紋識別,看完全懂了!
- 手機FPC廠之2017年度全球PCB百強企業排行榜
- FPC廠從八個角度讓你讀懂指紋識別
- 2015年NTI-100全球電路板百強企業排行榜,其中中國大陸上榜企業有34家!
- pcb廠家盤點俄軍經典AK系列步槍
- 指紋識別軟板之各類FPC在指紋模組中的應用
- fpc軟板廠家為你解析黑孔工藝
- 柔性線路板給你推送的最新資訊‖2016中國印制電路板行業50強
最新資訊文章
- 新能源汽車動力之電池FPC補強整體解決方案
- FPC廠家帶您了解指紋識別軟板的POS機
- 你了解線路板軟板品質意識有哪些方面的內容嗎?
- 探索柔性線路板的奧秘并揭秘廠家常用PCB板材
- 電子產業中不可缺的一環——軟板廠
- 如何選擇高品質柔性電路板?
- 介紹FPC廠FPC與PCB廠PCB
- 2024年深聯親子活動報名已開啟,快來報名吧!
- 指紋識別軟板的技術成果有哪些?
- 【熱點 】電動汽車軟板用量大 臺廠卡位布局






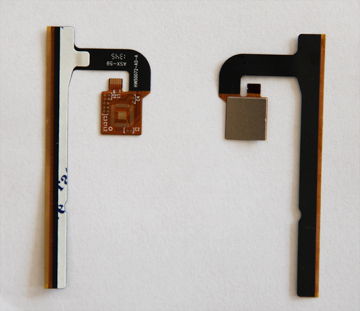
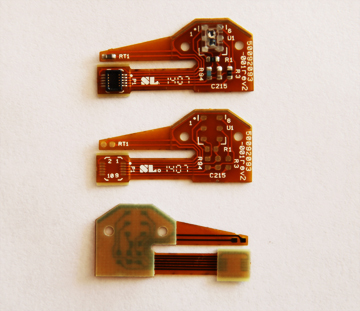






共-條評論【我要評論】